行(háng)業應用
BGA封裝底部填充
一、麵臨的挑戰
高可靠性要求的航空航天航海、動車(chē)、汽車(chē)、室外LED照明、太陽能及軍工企業的電子產品,電路板(bǎn)上的焊球陣列器件(BGA/CSP/WLP/POP)及特殊器件,都(dōu)麵臨著微小型化的趨勢,而(ér)板厚1.0mm以下的薄PCB或柔性高密度組裝基板(bǎn)、器件與基(jī)板(bǎn)間的焊接點(diǎn)在機械和熱應力下作用下變(biàn)得很脆弱。
二、解(jiě)決方案
針對BGA封裝,凱恩(ēn)KY提供底部填充工藝解(jiě)決方案——創新型(xíng)毛細流動底部填充劑(jì)。把填充膠分配塗敷(fū)到組裝好的器件邊緣,利用液體的“毛細效應”使膠水(shuǐ)滲透填充滿(mǎn)芯片底部(bù),而(ér)後加熱使填充膠與芯片基材、焊點(diǎn)和PCB基(jī)板三者為一體。
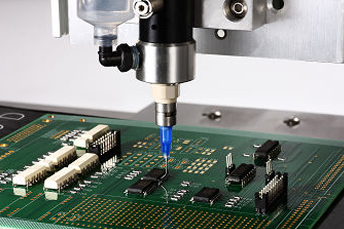
工藝優勢:
1、高流動(dòng)性、高純度、單組份,極細間距的部件快速(sù)填充,快速(sù)固化(huà)能力;
2、能夠(gòu)形成均勻(yún)無空洞底部填充層,可消除由(yóu)焊接材料引起的應力,提高元器件的可靠性和機械性能,為產(chǎn)品(pǐn)的(de)跌落、扭曲、振動、濕氣等提供很好的保護。
3、可返修係能,可對電(diàn)路板再次利用,大大節省(shěng)成本(běn)。
下一篇:LED燈具












